
- 部品実装の一貫生産工場としてSMT・SMD・DIP・組立・完成検査等
ニーズに合わせて試作や少量品種から大量生産まで可能な設備を取り揃えております。 - 高密度・高精度(±50μm)・微細・大型等の各種実装を高い技術にて対応しております。
- ファブレス企業様には弊社製造加工施設をご提供します。
超ファインピッチ印刷
約20年前に主流となっていたギャップ印刷方式では、ブリッジが発生しやすく印刷形状が安定しないという問題があります。
弊社では、はんだのチキソトロピック特性を利用した充填方式の装置を活用しバンプ印刷などの超ファインピッチ印刷にて対応しております。
0402/0603/1005対応高速部品搭載
近年の電子回路基板は、更なる高密度実装が要求されています。
それに対応して微少チップ部品の狭隣接実装・狭ピッチCPS(Chip Size Package)による高密度実装への対応が必要となります。
弊社では、1005や0603は勿論、0402といった微少チップ部品にも対応しております。


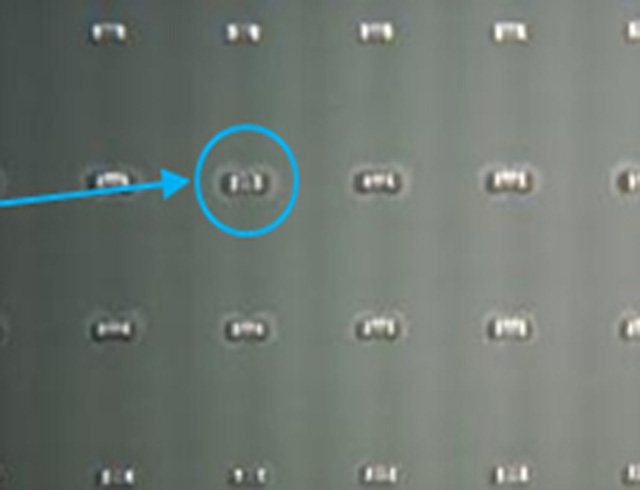
異形部品搭載
BGA(Ball Grid Array)/CSP(Chip Size Package)/フリップチップなどの異形部品搭載にも対応しております。
BGA

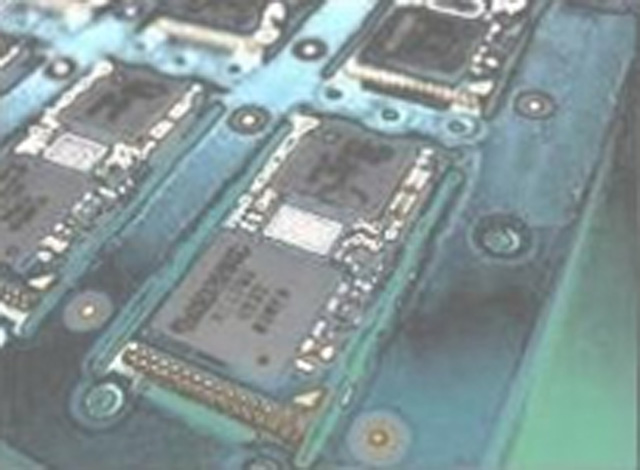

*部品周辺にリード端子を持つのが”QFP”や”SOP”。
小型で多ピン化を可能としたパッケージとして開発されたのがBGA。
CSP
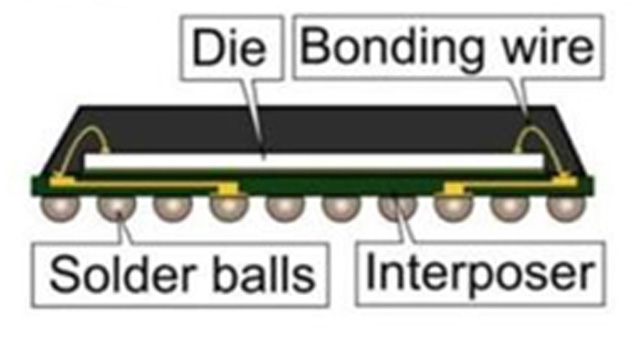
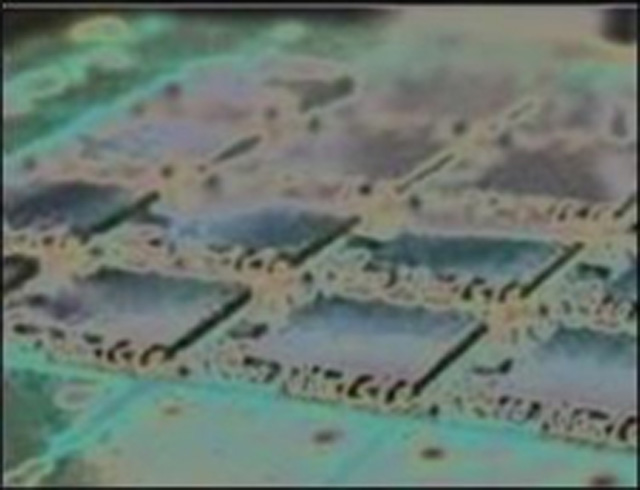

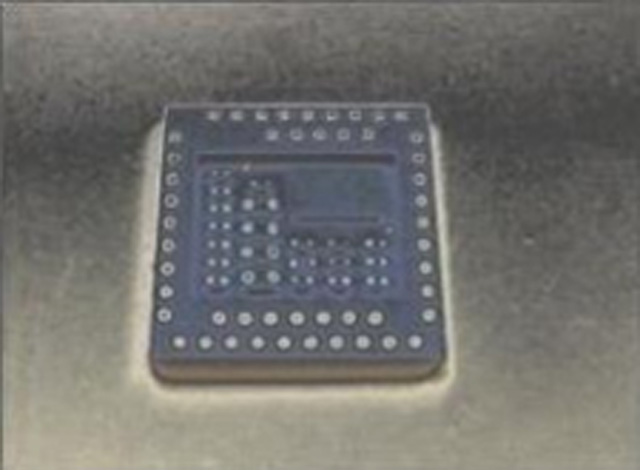
キャビティ内CSP実装品
フリップチップ(フラックス転写技術)
Transcribe Flux
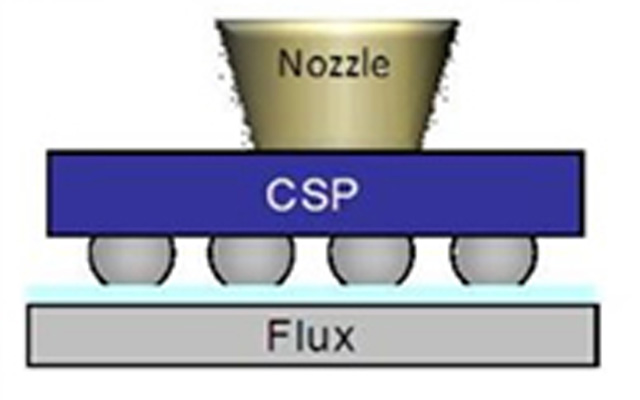
Mount
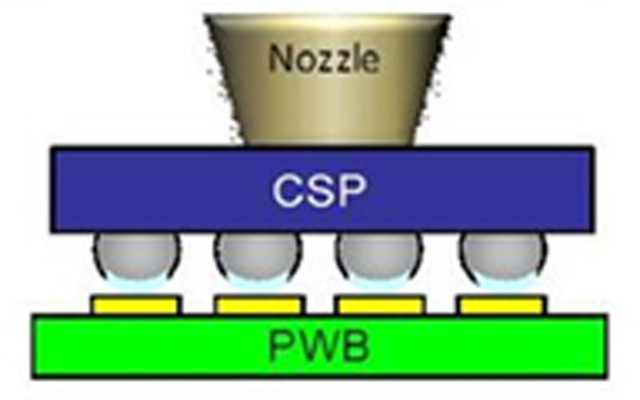
*実装面積が小さく、配線が短いために電気的特性が良く、小型化・薄型化が進む携帯電話などに多く使用されています。
システムインパッケージ
複数のチップを1つのパッケージ内に封止した半導体製品であり、特異な実装技術を要する場合があります。
例えば、マイクロプロセッサーとDRAM及びフラッシュメモリの組み合わせを1つのパッケージ内に三次元構造で立体的に組み合わせたもの。
※お客様にて設計・開発の段階よりタッグを組んで取り組ませて頂きます。


3D実装
複数のチップをパッケージ内で3次元方向に積層して実装する技術。
システムインパッケージを可能にするには3D実装技術が必要となります。
※お客様にて設計・開発の段階よりタッグを組んで取り組ませて頂きます。

検査装置
自動画像検査装置 (インライン・アウトライン)
※インラインでもアウトラインでも対応出来ます。
X線検査装置による信頼性評価